服务热线
15501138672
应用文档
真空紫外(172 nm)光刻实现亚 400 nm 分辨率:在块体聚合物及半导体上薄膜中的纳米结构与光学元件光烧蚀图案化
Andrey E. Mironov,Jinhong Kim,Yin Huang,Austin W. Steinforth,Dane J. Sievers,J. Gary Eden
利用平面微等离子体阵列灯产生的非相干真空紫外(VUV)辐射,对块体聚合物或薄膜进行精密光烧蚀,已经实现了一种新的光刻工艺:在该工艺中,丙烯酸树脂、聚碳酸酯或其他聚合物可作为“干法光刻胶”。采用强度低至约 10 mW·cm⁻² 的 172 nm 灯源,并配合熔融石英接触式掩模,可在聚甲基丙烯酸甲酯(PMMA)、丙烯腈-丁二烯-苯乙烯(ABS)等商用级块体聚合物表面,或旋涂在硅基底上的薄膜中实现表面图案化,形成沟槽以及任意复杂的三维结构,其深度重复精度可达约 10 nm。
当基底处 172 nm 光强为 10 mW·cm⁻² 时,对 PMMA 的线性化烧蚀速率在曝光时间 t ≤ 70 s 范围内约为 4 nm·s⁻¹,但随后逐渐下降;当 t 超过约 300 s 后,聚合物去除速率逐步趋于饱和,约为 0.2 nm·s⁻¹。通过两次或多次曝光,通常在 10–300 s 的总工艺时间内,即可在块体丙烯酸材料或厚度为 40–200 nm、位于硅上的丙烯酸薄膜中制备出复杂图案。该光烧蚀过程的精度非常高,目前可重复制备的最小横向特征尺寸约为 350 nm,其限制因素似乎主要来自光掩模本身。该光刻工艺的多功能性和高精度体现在多个示例中,包括:铝纳米反射镜阵列的制备——每个反射镜位于直径 350 nm 或 1 μm 的硅柱顶部——以及在 PMMA 中烧蚀出透射光栅、菲涅耳透镜等光学元件。
真空紫外(172 nm)光刻实现亚 400 nm 分辨率:在块体聚合物及半导体上薄膜中的纳米结构与光学元件光烧蚀图案化
本文为 2020 年 Nanoscale HOT Article Collection 专题论文之一。
过去四十多年里,光刻技术的快速进步,在很大程度上推动了半导体器件工业持续跟上摩尔定律的发展步伐。早期的光学曝光系统依赖汞原子弧光灯产生的 g 线和 i 线辐射(分别为 436 nm 和 365 nm),直到今天,大量电子和光子器件的图案化工艺仍以这种非相干光源为基础。然而,真正加速实现亚 100 nm 特征尺寸进程的,是转向更短波长的 ArF(193 nm)和 KrF(248 nm)准分子激光。Jain 等人在 1982 年首次将这类激光引入光刻之后,193 nm 曝光系统最终实现了 14 nm 技术节点这一非凡成就。虽然脉冲深紫外激光(约 200–250 nm)以及近年来用于极紫外(EUV,13.5 nm)光刻的激光产生锡等离子体光源,应被视为器件特征尺寸持续缩小的关键推动力,但这种进步代价高昂。越来越复杂的步进机,以及其购置和维护成本,已经使最先进光刻工具的可及性越来越低。
然而,对于研究或光电器件及系统制造中相当一部分图案化需求而言,EUV 曝光系统所提供的分辨率其实并不必要,因此开发低成本、短波长的工艺和曝光工具具有现实意义。
本文报道了一种可扩展、精确且快速的光刻工艺,该工艺基于新近开发的平面灯所提供的非相干 172 nm 真空紫外辐射,对多种聚合物薄膜进行光烧蚀。具体来说,在真空紫外区 172 nm(光子能量 hν = 7.2 eV)条件下,使用灯强低至 10 mW·cm⁻² 也可以对包括丙烯酸和聚碳酸酯在内的多种聚合物实现高达 4 nm·s⁻¹ 的材料去除速率,这为一系列接触式或投影式光刻工艺奠定了基础。这些工艺可在 1 个大气压氮气环境中运行,且不需要对灯光空间分布进行均匀化或修改。通过一次或多次曝光、总曝光时间通常为 10–300 s,即可在聚合物薄膜和块体材料中制备复杂纳米结构,而沟槽及其他特征的深度通常可控制到 10 nm 的精度。
目前所使用的光掩模由电子束直写制备,但横向分辨率(最小特征尺寸)暂时受限于约 350 nm。若采用更高质量的熔融石英掩模,则有望实现亚 200 nm 特征。因此,该工艺目前已展示出的分辨率优于商用 i-line 工具通常提供的约 0.8–2 μm 线/空分辨率。172 nm 聚合物光烧蚀目前可实现的图案分辨率(约 350 nm)小于通信波长范围(1450–1650 nm)的 λ/4,在深红到近红外波段则小于 λ/2。由此可见,这种光刻能力能够以紧凑、低成本的方式制造布拉格光栅以及其他适用于 700–1600 nm 波段光纤与半导体激光器的光学元件和结构。
无论具体应用为何,采用 172 nm 灯作为曝光源还可以省去有机光刻胶中针对特定波长引入的光敏分子,例如重氮萘醌(DNQ),因为 7.2 eV 光子可直接通过断裂主链和侧链中的化学键来改变聚合物树脂本身。因此,可以不再需要光敏剂以及高分子量聚合物树脂,并可用异丙醇和丙酮等毒性较低的醇类和酮类替代传统显影液。本文报道的这种单组分光刻胶化学体系,在降低真空紫外曝光设备成本和复杂性的同时,也显著减少了相较传统光刻胶工艺所产生的废液量和毒性。
为了评估这种光刻工艺的性能与潜力,作者制备并测试了若干离散光学元件和阵列,包括大面积铝纳米反射镜阵列——每个反射镜位于直径 350 nm 至 1 μm 的硅柱顶部——以及菲涅耳透镜、反射光栅和透射光栅。由于 172 nm 对聚合物薄膜的光烧蚀具有高精度,研究人员已制备出焦距 50 mm、在 632.8 nm 下强度聚集因子达 380 的菲涅耳透镜,以及一阶衍射效率达到 40% 的透射光栅。利用该 VUV 光刻工艺所定义的图形,还制备了通过电沉积金而形成的等离激元阵列。
早在 20 世纪 80 年代初,人们就已知道某些有机物以及动物、人类组织在 VUV 激光照射下会发生非热光烧蚀。然而,尽管文献中曾报道利用该机制精密加工人类头发,以及 Trokel 等人在 1983 年演示了牛角膜的非热烧蚀,但这些研究及其后续工作基本都在 193 nm 条件下、使用峰值强度约 10 MW·cm⁻² 的脉冲 ArF 激光进行。本文结果的一个意外之处在于:尽管脉冲灯的峰值辐射功率只有几百瓦,至少比 193 nm 激光低四个数量级,但在 172 nm 下仍可实现聚合物光烧蚀。
事实上,2–3 十年前,人们就已意识到 150–200 nm 真空紫外波段在光刻中的潜力,但原本的首选光源——157 nm 的 F₂ 激光——后来被证明并不适合,因为其光谱为多线输出,且对光学系统要求复杂。随后,出于完全不同的应用动机,一些生物医学研究团队报道了使用 Xe₂(172 nm)灯和金属丝网掩模,在聚二甲基硅氧烷(PDMS)上实现低分辨率(50 μm)光图案化。这些工作主要面向细胞图案化、生物分子固定和组织工程。也是在这一背景下,Hozumi 等人报道了通过 172 nm 灯在空气中产生的激发分子和自由基与聚甲基丙烯酸甲酯(PMMA)表面作用,实现 PMMA 表面选择性亲水化。
而在 2006 年,Asakura 等人报道了一种光刻工艺,其中低强度 172 nm 灯照射处于不同空气压力下的 PMMA 薄膜,演示了正胶和负胶两种光刻模式,但材料去除依赖于光化学生成的臭氧与聚合物的相互作用。与前述实验一样,空气的存在是实现光刻蚀过程的必要条件。除此之外,172 nm 辐射对有机薄膜的光化学作用,还曾被用于抗蚀剂图形冻结、镜面有机物的光化学清洗等研究。
VUV 光源格局在 2017 年发生了重要变化。Park 等人宣布实现了平面、超薄型灯源,在 172 nm 处可输出高达甚至超过 300 mW·cm⁻² 的强度,峰值发射功率达 600–800 W,带宽约 9 nm。有效发光面积约 100 cm² 的灯现已能够在 172 nm 产生超过 25 W 的平均功率。若作比较,这种前所未有的 VUV 灯平均功率和峰值强度,比太阳在该波段(地球大气层外并假设相同带宽)的辐照高出五个数量级以上。此外,天鹅座恒星 2 Cygni 是少数辐射峰值位于 175 nm 左右的恒星之一,对应“颜色温度”约 16,500 ± 200 K。由于这种灯强也显著高于此前的商用品,其电光效率(wall plug efficiency)超过 20%,而拥有成本至少比 193 nm 准分子激光低 2–3 个数量级,因此广泛推进材料的光化学加工已成为可能,因为每摩尔 VUV 光子的成本骤降,意味着商业应用具有可行性。同样重要的是,这种灯源可能使部分现有光刻系统重新回归以灯为基础的结构,同时将曝光波长从基于汞灯 i-line 系统的 365 nm 缩短至 172 nm,缩短超过一半。该光源还有两项优势:其一,发射波长略高于氮气透明极限(约 160 nm),这使得基于 172 nm 的光刻系统可在常压氮气环境中工作,无需抽真空;其二,这种灯在几十千赫兹重复频率下的占空比通常为 5–10%,比 100 Hz–1 kHz 工作的 ArF 激光高出 3–4 个数量级,因此在降低设备成本的同时,曝光时间仍可控制在几十秒或更短。
本文所有实验均采用 Cygnus Photonics 公司生产的 172 nm 接触式掩模光刻系统(π²-Cygni)完成。该曝光工具内置一只 50 mm × 50 mm 的灯,位于基底上方 2 cm 处,在目标表面(通常为硅片或商业/光学级聚合物样品)处可提供 10 ± 2 mW·cm⁻² 的 172 nm 实测强度,且灯输出窗口有效区域内的强度均匀性优于 3%。灯强通过 Hamamatsu 专为 172 ± 15 nm 波段设计并校准的能量探测器定期监测。
对于使用硅基底的实验,直径 50 mm 的硅片首先按标准程序用丙酮、异丙醇(IPA)和去离子水清洗,然后在其表面旋涂厚度 40–200 nm 的聚合物薄膜。接着将具有目标几何图案(但无邻近效应修正或其他分辨率增强设计)的熔融石英光掩模覆盖在基底上。在曝光前 10 s 以及整个曝光过程中,以 0.5 scfm(约 14 L·min⁻¹)的流量向系统中通入研究级氮气,以排出腔体内空气。通常经过 20–40 s 的掩模曝光后,将样品取出,并通过扫描电子显微镜(SEM)、三维激光扫描共聚焦显微镜(Keyence VK-X1000,405 nm)、接触式表面轮廓仪(Sloan Dektak3ST)和光学显微镜进行表征。
实验过程中发现,在制备沟槽和其他结构后,表面会出现颗粒状残留物。因此,在这类情况下,样品曝光后需用 IPA 冲洗 5 s,以去除那些未被光烧蚀直接从沟槽或空腔中抛出的碎屑。虽然目前尚未完全明确光烧蚀产生的碎片成分,但显然在常压氮气背景中,被抛射颗粒的初始速度足够高,使大部分光化学碎片可以逃离浅沟槽或空腔。对冲洗前后沟槽深度的仔细测量表明,两者之比精确为 1:4。也就是说,如果在冲洗前,丙烯酸中形成的沟槽深度为 50 nm,那么冲洗后深度将为 200 nm。后文将进一步讨论,对聚合物表面深结构进行冲洗并不会降低工艺的空间分辨率,反而会提高之。还必须强调的是,这种光刻工艺不需要常规光刻胶处理中常见的其他液体处理步骤。
除了聚合物薄膜/基底体系外,作者还广泛测试了其他多种有机材料和聚合物,包括 ABS、聚碳酸酯以及二甘醇二烯丙基碳酸酯(ADC,也称 CR39)。研究发现,无论表面是否达到光学级,这些材料都可以实现精密光图案化。在若干实验中,还通过 172 nm 光烧蚀在薄聚合物膜中打开窗口,再在其内电沉积金或溅射铝。
图 1 总结了块体 PMMA 在曝光时间 t 可达约 900 s 时的光烧蚀速率测量结果。实验中使用厚约 3 mm 的 PMMA 板(非光学级),切割成约 76 mm × 76 mm 的方片,并在放入 VUV 光源/掩模系统前立即去除表面保护纸。样品在基底表面光强固定为 10 mW·cm⁻² 条件下单次曝光后,用 IPA 冲洗 2 s、去离子水冲洗 2 s,此过程重复 5 个循环。大量测量结果表明,在给定灯强和曝光时间下,所得深度具有惊人的重复性,误差在 10 nm 以内,且主要受限于光学轮廓仪分辨率。因此,图 1 中的不确定度小于图中数据点的符号直径。
从图 1 可见,初始线性化光烧蚀速率约为 4 nm·s⁻¹,但当 t 超过约 70 s 后开始出现饱和趋势。对于 t 超过约 300 s 的曝光,聚合物去除速率趋于常数,约为 0.2 nm·s⁻¹。图 1 上方横坐标显示,在 PMMA 中制备深度 300 nm 的沟槽需要累计曝光剂量约 1 J·cm⁻²。对沟槽或圆柱形结构的侧壁与底部轮廓进行大量观察后发现,其垂直侧壁相对于法向垂直平面的倾角约为 25–35°,并由多个因素决定:表面平整度、掩模与样品的接触情况以及入射辐射的准直性。正如前文所述,后冲洗去除颗粒残渣不会降低工艺分辨率。具体而言,直接光烧蚀仅贡献最终沟槽深度的 25%。曝光后出现在沟槽、通道和圆柱内的颗粒,显然是聚合物经 VUV 光化学改性后进一步降解为低分子量烃链的结果。作者将其归因于多个光学过程,包括 PMMA 主链中 C–C 键断裂,从而生成 MMA 单体。针对不同聚合物光解产物并通过残余气体分析仪(RGA)检测的研究仍在进行中,但初步结果表明,酯羰基侧链中的 C–C 与 C–O 键裂解也起了重要作用。
无论 PMMA 及其他聚合物碎裂的具体机制是什么,轮廓测量表明:例如,在沟槽被残渣填充的部分(即冲洗前),侧壁坡度基本保持不变。换言之,曝光后碎屑占据沟槽体积的 75%(与曝光时长无关),但沟槽截面会随深度单调连续减小。通过对沟槽宽度和侧壁轮廓的分析,作者发现当前可实现的最大分辨率 a 满足 a = 2.5d,其中 d 为特征深度。这等价于目前可达到的最大纵横比约为 0.4。因此,深约 700 nm、横向特征尺寸约 1.75 μm 的沟槽可以方便制备;而较浅结构,如约 150 nm 深的沟槽,则可实现约 370 nm 的横向分辨率。需要说明的是,这些结论适用于商用级聚合物样品;尽管基底光学质量较差,仍能实现如此分辨率,确实令人惊讶。
图 1:在块体丙烯酸板中光烧蚀形成的沟槽深度与 172 nm 曝光时间的关系。所有数据均以 PMMA 为基底,并在基底表面光强固定为 10 mW·cm⁻² 条件下测得。每个深度数据均在 IPA 冲洗后测量。上方横坐标表示累计曝光剂量(J·cm⁻²),每个测量点的不确定度小于图中空心圆符号直径。
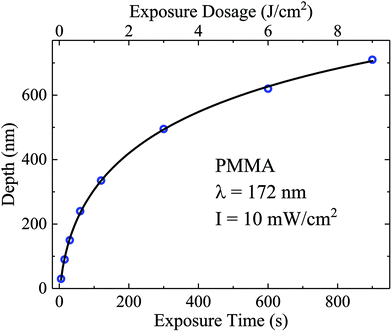
图 2 为在块体 PMMA 中光烧蚀得到的一个代表性低分辨率图案的光学显微镜图像。该美国空军标准分辨率图样中,可观察到小至 5 μm 的特征,且商用级聚合物块体内部可见若干气泡。需要指出的是,通道和其他特征的底部精确复制了被加工基底原有表面形貌。

图 3 给出了若干图案及特定结构的 SEM 图像,这些图案制备在旋涂于硅基底上的 55 nm 厚 PMMA 薄膜中。在图 3(a)–(c) 中,较亮区域表示在聚合物中光烧蚀出的通道,图 3(c) 为一条宽约 1.2 μm 线条的放大图。这三种图案的曝光时间均为 40 s。图 3(d) 则展示了该工艺同时制备明场和暗场图案的能力(分别位于图的下部和上部)。
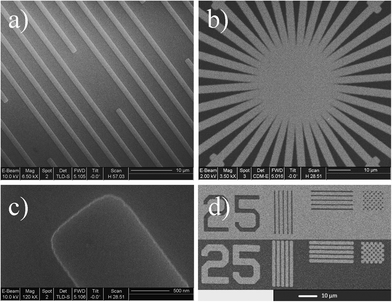
图 2:通过熔融石英掩模,在 172 nm 辐射照射下于厚 3 mm 的块体 PMMA 板中复制出的标准(美国空军)分辨率图样的光学显微照片。该图像对应 60 s 曝光,并进行 5 个循环的 2 s IPA 冲洗和 2 s 去离子水冲洗。注意,该商用级聚合物样品表面下方存在小气泡。
图 3:172 nm 光烧蚀 40 s 后在 PMMA 中形成的若干图案的 SEM 图像:(a) 约 1.2 μm 宽线条阵列;(b) 一个轴对称图案;(c) 一条约 1.2 μm 宽线条的放大图;(d) 通过 172 nm 曝光工艺制备的明场和暗场图案。两类图案中最小特征均为 800 nm。
过去两年中,对包括 PMMA、ABS 和 CR-39 在内的多种聚合物进行的实验一致表明,熔融石英掩模中的亚 400 nm 特征可以被成功复制到块体聚合物和硅上的薄膜中,而横向空间分辨率(约 350 nm)当前主要受可用光掩模限制。
例如,图 4 为图 3(b) 所示那类圆形尖端阵列图案中某一尖端的 SEM 图像。图 5 和图 6 则给出了其他经单次曝光在 PMMA 中形成图案的表面形貌图。这些图像由三维激光扫描共聚焦轮廓仪记录。图 5 所示图案由宽约 3 μm、深 500 nm 的沟槽组成。图上方虚线表示下方线剖面的采样路径。图中在直角转弯及中心交叉处可见的线宽收缩是有意设计在掩模中的,用于展示可达到分辨率的一个侧面。图 6 则为一个“太空侵略者(Space Invaders)”图案的激光共聚焦显微图,其深度为 240 nm,通过 60 s 曝光制得。
通过对同一基底进行多次曝光,可以快速且精确地在各种聚合物表面制备复杂三维图案与结构。图 7 展示了迄今在块体丙烯酸基底中制备的若干多层图案。图 7(a) 为一幅假彩色地形图,使用第一种工艺制得:基底在两次各 1 min 的曝光后,均分别进行 IPA 和去离子水冲洗;两次曝光之间,将掩模在平行于基底表面的平面内平移。每次曝光对应的烧蚀深度约为 240 nm,因此图中每种颜色都代表一个 240 nm 厚的层级。例如红色区域表示从样品表面下 480 nm 延伸到 720 nm 的台面。采用相同方法但分别进行两次或三次曝光制备的其他图案见图 7(b) 和图 7(d)。图 7(b) 中采用 5 μm 线/空掩模,在两次曝光之间旋转 90°;图 7(d) 则展示了三次曝光并在每次曝光后将同一掩模在样品表面平移所形成的结构。该结构包含四个层级,图像视场为 97 μm × 73 μm。上述示例中每次曝光时间均为 1 min,图 7(a)、(b) 的视场均为 97 μm × 73 μm,而图 7(d) 为 280 μm × 212 μm。
图 4:图 3(b) 所示图案中可实现的最小特征尺寸(约 350 nm)的 SEM 图像。
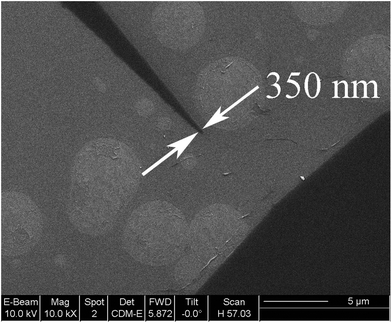
图 5:利用激光共聚焦轮廓仪记录的 PMMA 图案假彩色表面形貌图,图案由名义宽度约 3 μm 的线条组成。在中心交叉附近可见线宽收缩,这是熔融石英掩模中预先定义的。图上方虚线表示下方剖面线位置(比例非严格一致)。由于该图案制备在块体(商用级)PMMA 中,因此底部深度(蓝色区域)的起伏主要来自基底原始表面形貌。
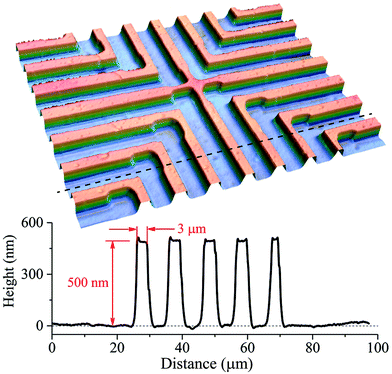
图 6:在块体(商用品质)丙烯酸表面形成的“太空侵略者”图案。该图案深度(即底部到表面的高度差)为 240 nm。
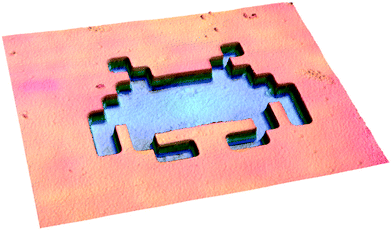
图 7:通过同一或不同光掩模对聚合物薄膜进行多次曝光,可方便获得若干纳米结构和几何图形。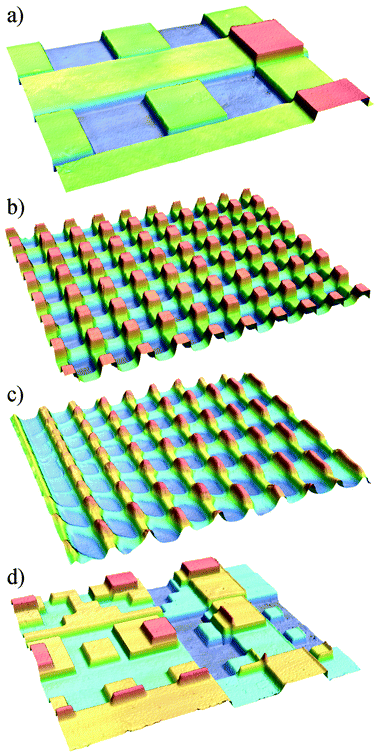
(a) 通过双重曝光在 PMMA 中制备的简单平面结构假彩色图。颜色编码区分三个层级,每层高度均为 240 nm;
(b) 经两次曝光并在两次之间将掩模旋转 90° 后制得的二维周期性三维结构;
(c) 通过双重曝光并将掩模在平行于样品表面的平面内平移而制得的“蜘蛛网”图案,其径向和方位对称性清晰可见;
(d) 通过三次曝光形成的四层结构,其中包含台面、竖直板等多种结构。所有曝光均持续 1 min,随后用 IPA 冲洗。图 (a)–(c) 的视场为 97 μm × 73 μm,而图 (d) 为 280 μm × 212 μm。所有层厚均为 240 nm,颜色仅用于区分不同层。xy 平面与 z 轴比例未按真实比例绘制。
在制备图 7(c) 所示图案时,采用了另一种工艺流程:先后使用两张不同掩模对同一基底进行两次曝光。第一张掩模为类似图 3(b) 的圆形(轴对称)图案,由一系列等间距、尖端朝向圆心的三角形组成;第二张掩模则用于制备衍射光栅,为一维 5 μm 线/空阵列。工艺完成后,样品用 IPA 和去离子水冲洗。得到的结果是一个“蜘蛛网”阵列,本质上等价于周期变化的衍射光栅(即啁啾光栅)。若将冲洗步骤推迟到所有曝光结束后再进行,则会由于垂直侧壁陡峭度降低、空间分辨率下降,而使阵列特征边缘发生圆化和平滑化。对尖锐拐角进行圆化在微流控领域可能具有价值,例如可降低通道交叉处液体流速梯度。
172 nm 光烧蚀工艺的高精度为制备光学与微流控元件及网络打开了通路。光学领域尤其值得关注,因为它有望实现全聚合物网络,将聚合物光纤、透镜、光栅和波导集成在一起。图 8 总结了前文提及的 PMMA 光栅(线宽/沟槽宽和间距均为 5 μm)的衍射效率测量结果。在 632.8 nm 激光入射下,随着曝光时间增加(即沟槽烧蚀深度增加),衍射功率逐渐从零级转移到更高阶(±1、±2 和 ±3 级)。以一阶衍射数据为例,当沟槽深度约为 600 nm(见图 1)时,衍射功率约为 −4 dBm,对应一阶衍射效率约 40%。
图 9(a) 为在非光学级 PMMA 平板一侧制备出的菲涅耳透镜的俯视光学显微图。该透镜通过 3 min 曝光、在约 10 mW·cm⁻² 的 172 nm 光强下制备,沟槽深度为 390 nm;透镜为 14 环设计,总直径 1 mm,焦距 50 mm。使用束腰直径约 1.0 mm 的 He–Ne 激光(632.8 nm)表征后发现,其焦斑尺寸为 28 μm(半高全宽,FWHM),测得的强度集中因子为 380。图 9(b) 则为该透镜局部表面的激光共聚焦轮廓图。尽管沟槽侧壁可见形貌起伏(“抖动”),但这并非光刻工艺引入,而是来自光掩模本身——即掩模图案呈像素化,且在薄 PMMA 膜中烧蚀出的特征精确复制了掩模结构。因此,172 nm 光刻的分辨率显然已经超过了该掩模本身的分辨率。可以预期,若采用高分辨率电子束掩模,将能够得到质量更优的纳米结构、光学元件和微流控网络。
图 8:制备于非光学级 PMMA 平板上的透射光栅的衍射效率。图中给出了在 172 nm 曝光时间从 60 s 到 600 s 变化时,衍射到若干阶次(零级、±1、±2 和 ±3 级)的光功率。实心和空心符号分别表示正负级次。这些数据通过 He–Ne 激光(632.8 nm,基模)测得,并在每次灯曝光后对光栅进行表征。可见当曝光时间达到 600 s 时,一阶衍射功率(约 −4 dBm)已超过零级,一阶衍射效率约为 40%。

图 9:
(a) 在非光学级丙烯酸中通过 3 min 曝光制备的菲涅耳透镜俯视光学显微图;
(b) 该透镜局部的激光共聚焦轮廓图。
透镜总直径 1 mm,焦距 50 mm,环形沟槽侧壁的粗糙起伏完全来自光掩模分辨率限制。沟槽深度为 390 nm,在 632.8 nm、光束直径 1.0 mm 的激光照射下,透镜可形成 28 μm(FWHM)的焦斑。
将 172 nm 光刻与成熟的半导体器件制程结合,可制备出如图 10 所示的阵列。研究中首先在 100 mm Si(100) 晶圆上旋涂 Microchem 950 PMMA A2 光刻胶(分子量 950,000),测得膜厚为 55 ± 3 nm,随后在 150 °C 下硬烘 60 s。之后立即通过光掩模,以 10 mW·cm⁻² 或 70 mW·cm⁻² 的 172 nm 光强进行曝光。曝光 10–40 s,并进行 4 个循环的 IPA/去离子水冲洗(每次各 2 s),以在 PMMA 膜中打开窗口,然后在其中溅射铝。随后通过剥离去除剩余 PMMA 膜,并采用深反应离子刻蚀(DRIE)对硅基底刻蚀 10 min,以形成图 10 所示硅柱。利用铝圆盘(或方块)作掩模,刻蚀出了长度 11 μm 的硅柱。图 10 上排两幅图为大面积 1 μm 直径硅柱阵列的局部 SEM 图,每根柱顶均带有一个铝反射镜。作者还制备了更小直径的硅柱阵列,图 10 下排展示的是直径 350 nm 的柱阵列 SEM 图。右下图中可见柱体直径的周期性变化,这是 Bosch 刻蚀工艺的特征;同时在铝镜周边还能看到一个离平面凸起的环,这是剥离工艺所致。刻蚀过程对铝圆盘的下切会使每个反射镜边缘产生尖削形态。
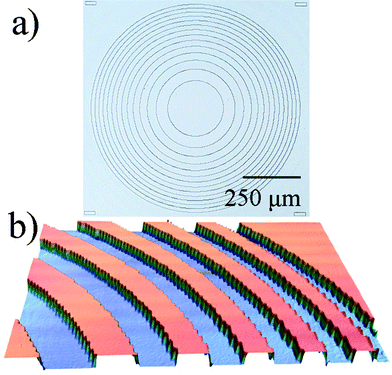
图 10:350 nm 或 1 μm 直径硅柱大阵列的部分电子显微图,每根硅柱顶部都固定有一个铝反射镜。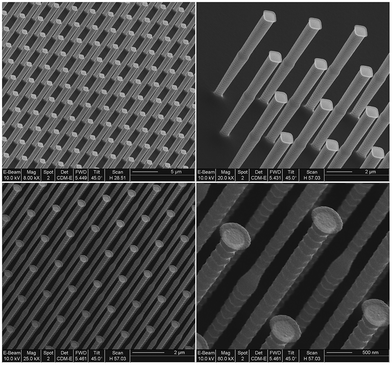
(左上)1 μm 准方形硅柱阵列局部,柱高 11 μm,观察角度相对硅柱轴线为 45°。在形成铝反射镜后,通过 Bosch 工艺(反应离子刻蚀)制得这些硅柱;
(右上)左图阵列局部的放大图;
(左下)直径 350 nm 柱阵列若干排的 SEM 图,同样以 45° 倾角观察;
(右下)数根直径 350 nm 硅柱的近景图,可见铝镜边缘的离面环。硅柱表面的周期性分段是 Bosch 工艺特征,铝镜则是通过在硅上 PMMA 膜中由 172 nm 光刻开出的窗口内溅射铝而制得。
为进一步展示 172 nm 聚合物光烧蚀在其他半导体工艺中的适用性,作者还实现了在硅基底暴露区域(即经光刻打开的窗口)上选择性电沉积金。在将硅片置入灯腔之前,先将原生氧化层浸泡在 0.8% HF 溶液中 20 s。曝光后,于 60 °C、10 mA 直流电流下在晶圆上电沉积金。图 11 给出了代表性结果:通过 PMMA 光刻胶中打开的窗口电沉积形成的宽约 2 μm 金线的 SEM 图。可以看到边缘非常锐利,金线宽度波动约为 150 nm。由于金在等离激元器件中也很重要,作者还利用类似工艺在硅表面电沉积了金点和金盘阵列。
本文最后一个示例是铝圆盘阵列的制备。图 12 展示了在 Si(100) 上制得的两种铝阵列的局部 SEM 图,这些阵列是通过在厚 55 nm 的 PMMA 膜中经 172 nm 光烧蚀打开窗口后,再溅射铝形成的。图 12(a) 为由 1 μm 方形单元组成阵列的一部分;图 12(b) 为另一阵列中 9 个约 500 nm 直径铝圆盘的放大图。
作者还使用类似工艺初步研究了特征分辨率对 VUV 曝光剂量的依赖。具体而言,在硅片上旋涂厚 55 nm 的 Microchem 950 PMMA A2 膜,并于 150 °C 下烘烤 60 s。通过厚 8 mm、未做邻近效应修正的掩模,以约 400 mJ 的 VUV 剂量进行曝光,并按前述方式进行 IPA 和水冲洗后,通过方形窗口溅射铝。随后通过剥离去除剩余聚合物。采用该流程时,1 μm 铝方块角部的曲率半径约为 240 nm。当 VUV 剂量提高 50%(至约 600 mJ)时,角部曲率半径增至 350 nm,铝方块尺寸扩大到 1.1 × 1.1 μm²。必须强调的是,这些结果仍是初步的,且包括前文所有工艺在内,都尚未经过充分优化。
图 11:沉积在硅上的金线俯视 SEM 图。图中给出了约 2 μm 宽金线阵列的两种放大倍率图像。该阵列首先通过在约 55 nm 厚 PMMA 膜上经光烧蚀定义,然后剩余聚合物作为负掩模用于后续电沉积。
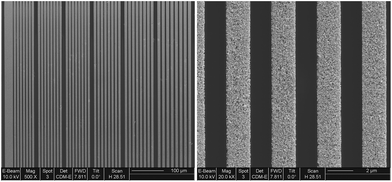
图 12:通过光烧蚀开窗口后溅射到 Si(100) 上的铝圆盘阵列俯视 SEM 图。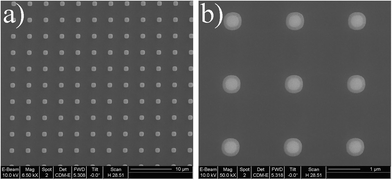
(a) 由 1 μm 方形单元组成阵列的局部;
(b) 另一阵列中 500 nm 直径铝圆盘的放大图。
55 nm 厚 PMMA 膜充当干法抗蚀层,经 20 s 曝光并进行 4 次 IPA 冲洗后,再沉积铝;剩余 PMMA 最后用丙酮去除。此类工艺看来对等离激元器件和结构制备具有潜在价值。
本文展示了一种基于平面 172 nm 灯和若干可充当光刻胶的聚合物的新型光刻工艺。文中数据表明,172 nm 光刻的分辨率优于汞灯 i-line 光刻,而其成本比 193 nm 曝光工具低多个数量级。复杂的多层结构和图案可以在块体丙烯酸材料(如 PMMA、ABS 或 CR-39)表面形成,也可以在旋涂于半导体基底上的聚合物薄膜中形成。172 nm 下的聚合物光烧蚀能够产生尺寸精确的纳米级特征,而已验证的最大分辨率(即最小横向特征尺寸)优于约 350 nm。预计若使用更高质量的光掩模,并优化聚合物膜厚及曝光/冲洗参数,则可实现小于 200 nm 的特征尺寸。
本文所报道工艺的速度和精度表明,结合 172 nm VUV 光刻与电子束光刻(两者都兼容 PMMA 光刻胶)的混合图案化方法,将有助于在同一片晶圆上快速形成纳米特征,而在从 VUV 曝光切换到电子束曝光时无需去除聚合物抗蚀层。作者预计,这类工艺将有助于快速、低成本地制造用于波前调控的光学网络与图案、微/纳流控结构、电子与光学元件和网络,以及生物医学和药理学相关器件。172 nm 光刻不仅对推动微纳技术和物理学研究具有吸引力,而且其低成本、高精度和高速特性也将扩大高校和工业实验室对 <200–400 nm 特征制备能力的获取。
上一篇:没有了!
下一篇:没有了!
上海市宝山区同济路2号1幢397室
15501138672
lyzhao@gsttech.cn
15501138672

Copyright © 2025 上海达灿光电科技有限公司版权所有 沪ICP备2025132989号-1 华大网络
服务热线

