功能一览

微光显微镜功能EMMI

该设备配备高灵敏度相机,可检测半导体器件在工作时产生的微弱光发射。它能够将这些微弱的光信号放大并成像,从而帮助用户观察到器件内部的微观发光情况,实现对半导体器件内部缺陷的可视化检测,如漏电、短路等问题引发的发光异常部位,适用于从成熟制程到先进制程芯片的失效分析测试。此外,PHEMOS-X还具有基本显示功能,如叠加显示、对比度增强、注释、刻度显示、网格显示、缩略图显示和拆分屏幕显示等,方便用户对图像进行分析和处理。
CMOS相机:针对可见光波段,适用于化合物半导体(如SiC)正面及背面分析。
应用场景:
● 化合物半导体器件底部分析
● 高压驱动器件耐压故障检测
InGaAs相机:针对近红外波段(900nm以上),适用于硅器件低压驱动和弱光检测。
应用场景:
● 硅半导体器件底部分析
● 低压驱动器件结故障检测
热点分析功能Thermal
可以检测由半导体器件缺陷引起的热辐射,从而定位热点区域。它通过高灵敏度的探测器捕捉这些热信号,并将其转化为可视化的图像,帮助工程师快速找到器件中因过热等问题导致的故障点,例如PN结漏电、栅氧缺陷等问题都可以通过热点分析来定位。
应用场景:
● 化合物半导体器件底部分析
● 高压驱动器件耐压故障检测
激光诱导检测IR-OBRICH
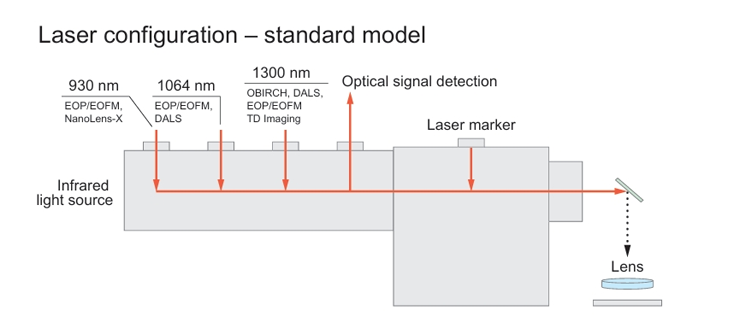
可配备多波长激光扫描系统,最多可以配备五个激光器,输出波长从可见光到近红外光不等。通过激光束诱导阻抗变化(OBIRCH)功能,能够从正面直接对功率MOSFET等器件的大漏电流进行定位观察。同时,激光诱导还可用于激发半导体器件,使其产生特定的光学或电学响应,以便更全面地分析器件的性能和缺陷,并且可与通用探针台结合使用,支持多种分析任务。
IR-OBRICH优势
优势 | 说明 | 应用场景 |
检测不发光缺陷 | 可定位 EMMI 无法检测的失效模式(如金属连线短路、开路) | 金属互连缺陷分析 |
主动激发机制 | 通过主动激发,能发现微小的、被动的 EMMI 无法发现的电阻性缺陷 | 微小电阻变化检测 |
高电阻通孔检测 | 对通孔底部高电阻区域敏感 | 通孔可靠性分析 |
背面分析能力 | 可从芯片背面进行分析,无需开封或移除保护层 | 背面照明器件、3D 芯片 |
